小而美二十亿美元市场 ArF、EUV光刻胶成未来发展趋势
半导体材料处于整个产业链的上游环节,对半导体产业起着重要的支撑作用,半导体材料可分为晶圆制造材料和封装材料,根据SEMI统计,2018年全球半导体材料销售额达到519亿美元,其中晶圆制造材料和封装材料分别占62%和38%。封装材料技术壁垒较低,高技术壁垒的晶圆制造材料是核心,大体可分为:硅片,光掩膜, 光刻胶,湿电子化学品(主要是高纯试剂和光刻胶辅助材料),CMP抛光材料(主要是抛光垫和抛光液),靶材,电子特种气体以及其他。光刻胶作为光刻过程的核心材料,其质量和性能直接决定集成电路的性能、良率。伴随着先进节点所需光刻胶分辨率的提升以及多次图形化技术的应用,光刻胶的成本占比以及市场规模呈现不断提升趋势,根据SEMI的数据,2018年光刻胶占晶圆制造材料比例约为5.4%,对应全球半导体光刻胶市场总规模为17.3亿美元,预计2019年市场规模可达17.7亿元。

光刻胶是微电子工艺制造中的关键材料,其技术原理是利用光化学反应经光刻工艺将所需要的微细图形从掩模版转移到待加工基片上的图形转移介质,由成膜剂、光敏剂、溶剂和添加剂等主要化学品成分和其他助剂组成。在光刻工艺中,光刻胶被均匀涂布在硅片、玻璃和金属等不同的衬底上,经曝光、显影和蚀刻等工序将掩膜版上的图形转移到薄膜上,形成与掩膜版完全对应的几何图形。光刻胶根据曝光和显影后的溶解度变化可以分为正型光刻胶和负型光刻胶:负型光刻胶:负胶在经过曝光后,受到光照的部分变得不易溶解,留下光照部分形成图形。胶是最早被应用在光刻工艺上的光刻胶类型,它拥有工艺成本低、产量高等优点。但是负胶在吸收显影液后会膨胀,这会导致其分辨率不如正胶。因此负胶经常会被用于分立器件和中小规模集成电路等分辨率不太高的电路的制作中。正型光刻胶:正胶在经过曝光后,受到光照的部分将会变得容易溶解,只留下未受到光照的部分形成图形;大规模集成电路、超大规模集成电路以及对感光灵敏度要求更高的集成电路(亚微米甚至更小尺寸的加工技术) 的制作,通常会选用正胶来完成图形的转移。
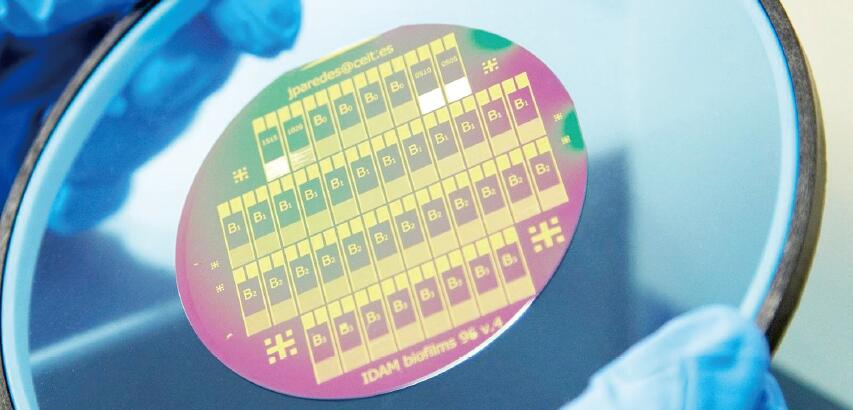
半导体集成度逐渐提升,ArF、EUV光刻胶成未来发展趋势高端光刻胶市场需求成长性显著,国产化程度较低。半导体光刻胶随着市场对半导体产品小型化、功能多样化的要求,而不断通过缩短曝光波长提高极限分辨率,从而达到集成电路更高密度的集积。随着 IC 集成度的提高,世界集成电路的制程工艺水平按已由微米级、亚微米级、深亚微米级进入到纳米级阶段。为适应集成电路线宽不断缩小的要求,光刻机的波长由紫外宽谱向g线(436nm)→i线(365nm) →KrF(248nm)→ArF(193nm)→F2、EUV(157nm)的方向转移。

ArF、EUV光刻胶叠加分辨率提升技术、多次图形技术不断推进工艺节点进步, 为光刻胶技术未来发展主要趋势。对应不同的光刻技术需要配套相应分辨率的光刻胶,目前半导体市场上主要使用的光刻胶包括g线、i线、KrF、ArF四类光刻胶。同时伴随着下游晶圆代工厂商不断布局先进工艺节点,由于正性(湿)ArF光刻胶结合分辨率增强技术可用于32nm/28nm工艺,采用多次图形技术,可以实现20 /14nm工艺(线宽均匀度(LWR)<2.5nm),而EUV光刻胶搭配EUV光刻机成为下一代光刻技术的未来主流选择,预计未来7nm、3nm等先进节点将应用EUV光刻胶。因此未来伴随着工艺的进步对于ArF、EUV类型 的光刻胶需求将会进一步提升。

分类资讯
热点排行
- 1两项指标均高于我们业务展望的中位数。
- 2用二氧化硅(SiO2)来消除边缘区域的电场
- 3该模块集成了几个基本组件
- 4新能源汽车产业的革新,离不开数字化、双碳两大时代底色
- 5应届毕业生大马,此前一直以为自己是足够幸运的那个
- 6从芯片行业的发展背景来看,芯片需离不开终端的发展
- 7全新高性价比工业级Cortex-A55核心板不限量发售
- 8中国电子展将以“创新强基 应用强链”为主题
- 9芯片厂商们披露业绩“创新高”
- 10元器件电子元器件的发展史其实就是一部浓缩的电子发展史






